直接接合の応用としてのマルチ電子線偏向器
| 内容 | 常温固層直接接合を用いたマルチ電子線偏向器の製法の一つを示している。半導体素子の微細化は、露光用の光波長に大きく依存する線幅(あるいは、ライン&スぺイス)に大きく影響を受ける。ところで、電子線ビーム径(焦点直径)は極めて微小(1~100nm)に収束可能(真空度 <10^-3Pa)である。このため、この電子線直接描画は上記の微細化に有効である。一方、生産のスループットを大きくするために、多数の電子線を同時に制御する必要がある。すなわち、個々の電子光学系を制御する偏向電極及び制御配線が必要となる。そこで、上記の複数の電子線偏向器作製における、直接接合の役割を示した。 |
| 特徴 | 上記電子線は空間電荷のため、空間を飛翔する。このため、多数の電子線偏向を制御するために、一つ一つの電子線に対応する通過孔(開口部)、及び通過孔の周囲に一対の制御電極(電子線を偏向させるための+極及び-極)を設ける。このため、これらの電子線通過孔数に対応する同数の一対の制御電極を設ける。従って、必然的に配線数は極めて多くなる。そこで、配線に特化した多層配線基板及び電極に特化した電極基板をそれぞれ製作し、そしてこられの基板をアライメントしながら直接接合(バンプ/パッド)する。このため、配線基板にも、電極基板と同様な電子線通過孔を設ける(一体での偏向器の作製は困難のため。)。 |
常温直接接合の一つの応用として、マルチ電子線偏向器の作製を示している。直接描画の可能な電子線露光は、一筆描きによる時間消費を余儀なくされる。そこで、各電子線を単独でそれぞれ制御された多数の電子線を用いることによって、この消費時間を短縮し、スループットを高める狙いが考えらている。一本単位の電子線偏向器は、電子線通過孔及びこの周囲に配置した一対の制御電極から構成される。そこで、多数の電子線偏向を各々同時並行して行うために、同様な機能を有する電子線偏向器の集合体が必要となる。この集合体の密度の増加と共にスループットは大きくなる。下図は、100μmx100μmnのピッチの正方マトリックスの一つのセル内に、一つ電子線を制御可能な偏向器を示している。制御用配線数及び電極は一つの偏向器に2個(一対)必要であるため、n個の上記セルの時2n個の電極及び配線が必要になる。そこで、電極(パッド電極)を設けた基板(電極基板)と多層配線(多層配線上にバンプ電極)を設けた基板(配線基板)をそれぞれ個別に作製する。そしてこの後、両基板をアライメントしながらこのパッド電極とバンプ電極を常温直接接合する。これらのパッド電極とバンプ電極の直接接合によって、両基板間の一体化を可能にする。Arプラズマで接合面を清浄化後、直接接合した接合界面は原子レベルで確りと接合している(下図参照)。上記のバンプ及びパッドはいずれもAu材料であるため、接合面清浄化はArプラズマを用いて短時間(下図参照)で済み、且つ直接接合までの一連の処理(位置決め、接合表面の清浄化及び直接接合)は、減圧排気後のAr雰囲気中(接合表面の清浄化)、及び大気中で可能である。
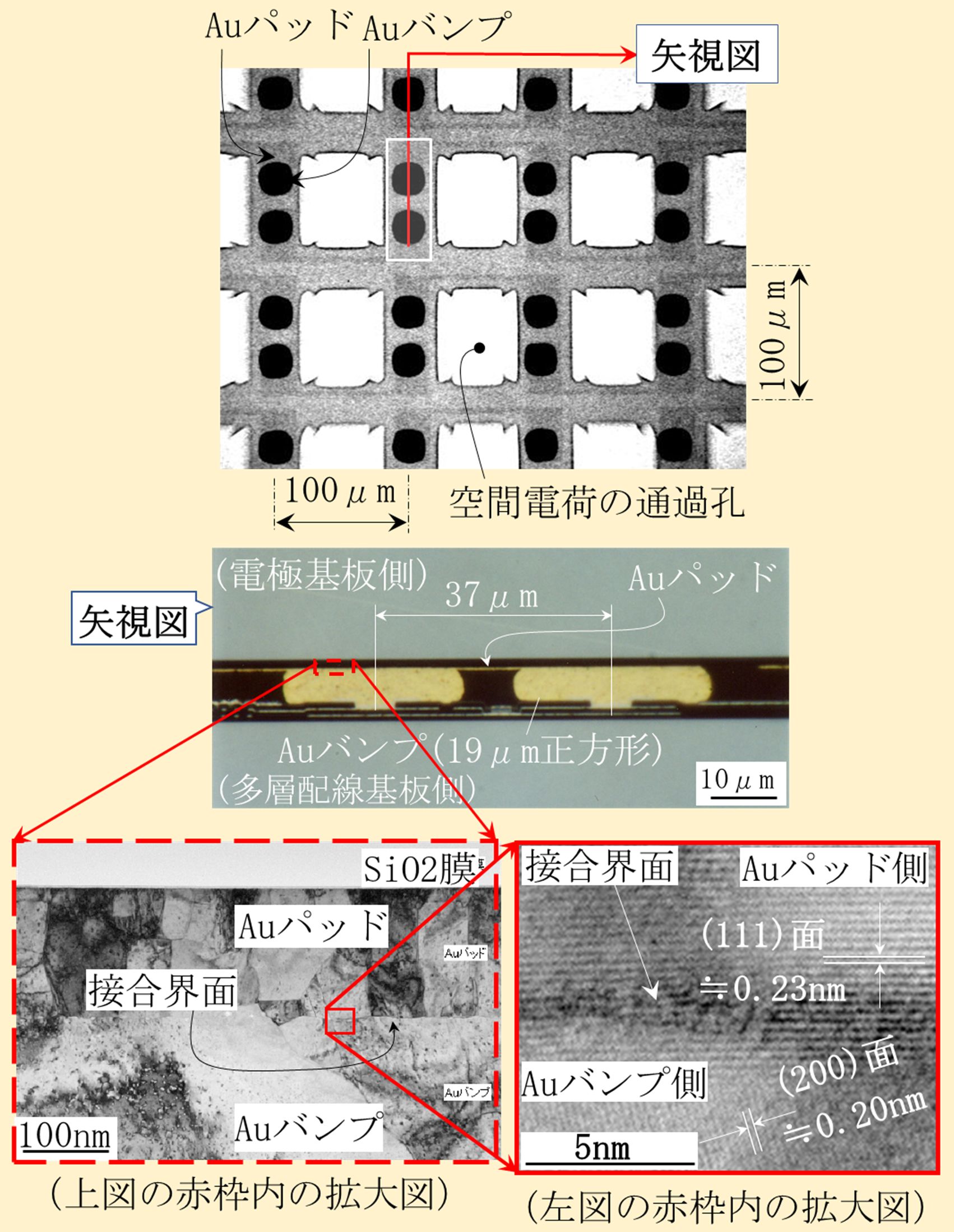
| 図の説明;一方の偏向電極基板(Si基板)に電子線通過孔を、この通過孔の周囲の枠内にAuパッドをそれぞれ設ける。他方の配線基板(Si基板)にも同様な電子線通過孔を、この通過孔の周囲の枠内にAuバンプをそれぞれ設ける。これらの両基板をアライメント(位置決め)後、常温直接接合したX線顕微鏡写真及び接合部の接合断面の電子顕微鏡写真を示す。尚、上図は、Cu電極を設けていない状態で両基板の常温直接接合の際に、Si基板の割れ等の不具合点のないことを確認するためのTEG試料を用いて示している。 |
| 偏向電極基板のパッドと配線基板(多層配線基板)のバンプの接合部(Au/Au)の断面の電子顕微写真からバンプ間の距離は約37μm、バンプ寸法(接合前、すなわち荷重印加による塑性変形前)は一辺19μmの正方形である。この接合部の断面拡大写真は、AuパッドとAuバンプが原子レベルで確りと接合している、ことを示している。 |
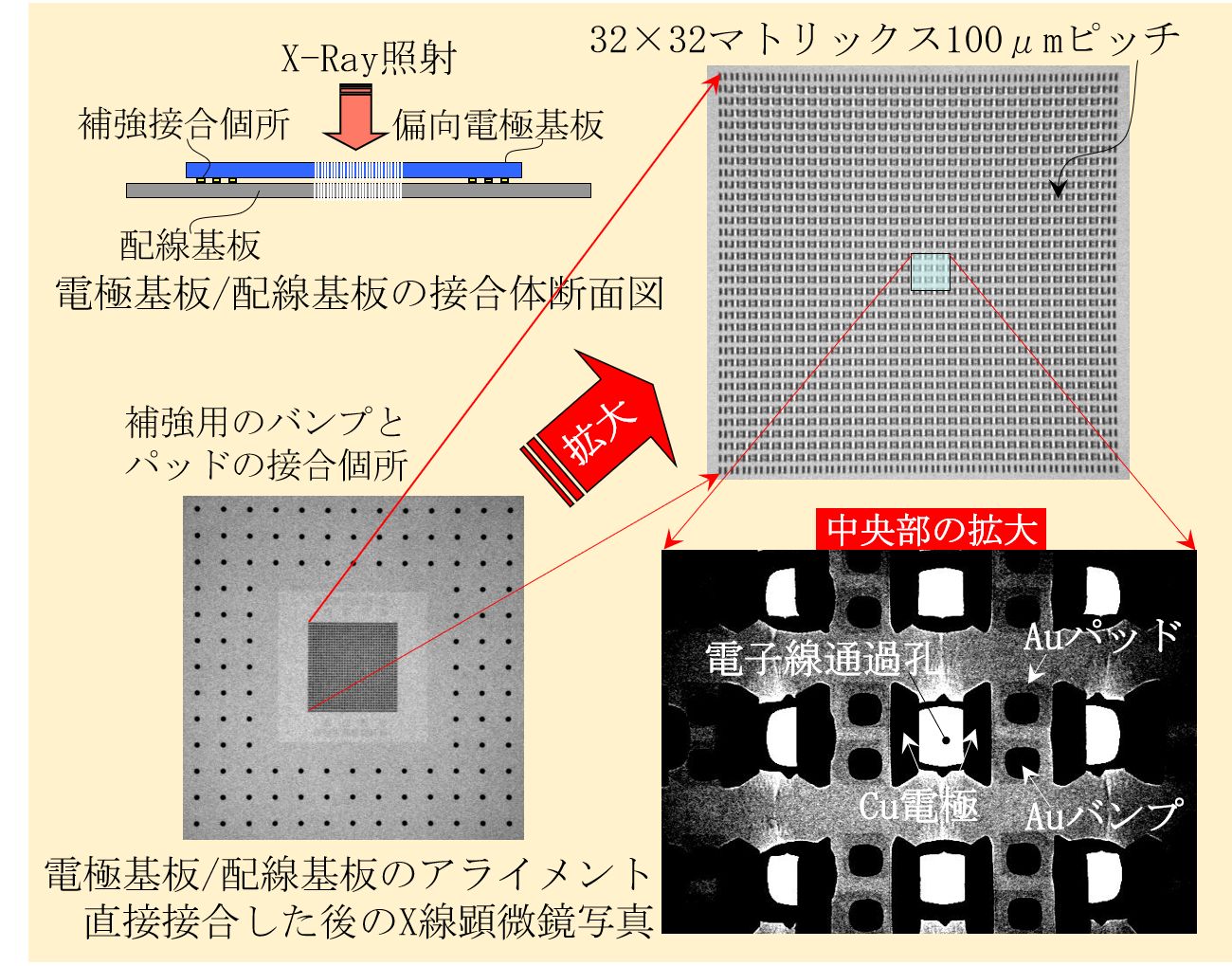
| 図の説明;一方のSi基板に電子線通過孔を設け、この通過孔の両側に沿って設けた一対のCu電極、このCu電極と電気的に連結したAuパッド、及びこれらの電子線通過孔を有するセルマトリックスの周囲に補強用Auパッドを配置した構成の電極基板と、対向する他方のSi基板に電子線通過孔、多層配線を通じて電気的に連結したAuバンプ、及びこれらのセルマトリックス周囲に補強用Auバンプを配置した構成の配線基板を、アライメントしながらAuパッド/Auバンプを直接接合した後の偏向器の平面図(平面写真)を示す。及び、上記直接接合後の断面を示している。 |
| 上記接合体のX線顕微鏡写真は、AuパッドとAuバンプ、及び整合された両者の電子線通過孔を示している。尚、放射状に直進するX線(電磁波)の特性のため、中心部でのみひずみを生じない正常な像を現す。 |
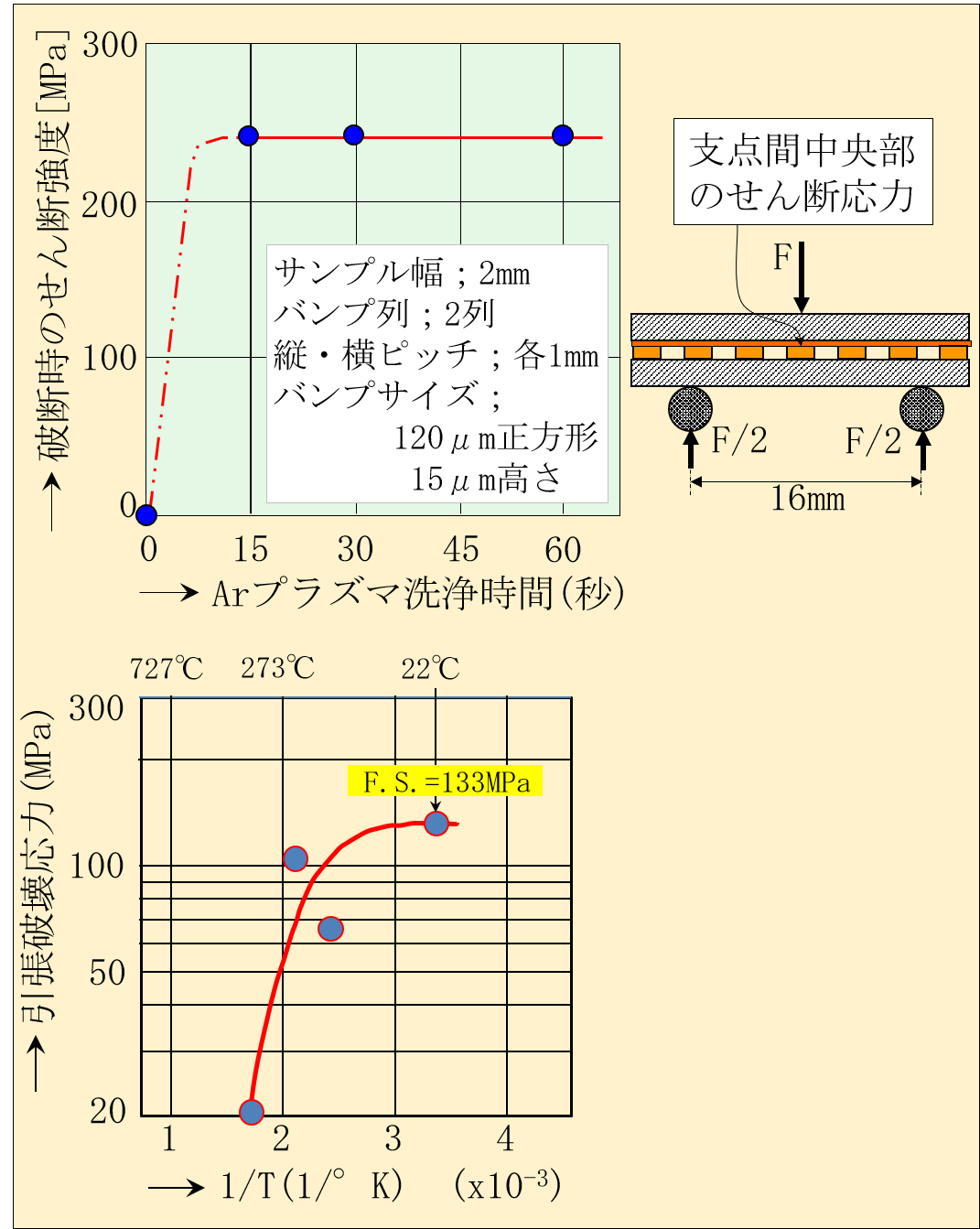
| 図の説明(上のグラフ);Arプラズマで接合表面を清浄化後のAuバンプ/Auパッドの直接接合において、このArプラズマ洗浄時間(処理時間)と接合後のせん断強度の関係を示す。ここでは、3点曲げ試験による破断時に試験片の中央部に生ずる接合界面のせん断強度を示す(Arプラズマ処理の効果を調べるための指標として用いた。)。(尚、本実験から。) |
| 図の説明(下のグラフ);Arプラズマで接合表面を清浄化後Auパッド/Auバンプの直接接合した試料の熱処理温度と引張破壊応力の関係を示す。(尚、本実験から。) |
